
在半导体制造过程中,清洗工艺是极为关键的一步,主要用于去除硅片表面在光刻、刻蚀、离子注入、薄膜沉积等环节所残留的颗粒、有机物、金属离子以及天然氧化物。为达到高洁净度标准,清洗工艺需依赖多种原材料的协同作用。这些原材料按照功能和使用方式可分为酸类、碱类、氧化剂、还原剂、有机溶剂、超纯水及特种气体等几大类。
常见酸类原材料包括硫酸(H₂SO₄)、氢氟酸(HF)、盐酸(HCl)和硝酸(HNO₃)等。硫酸常与过氧化氢(H₂O₂)组成混合液,用于去除有机污染物和光刻胶残留;氢氟酸用于去除硅表面上的天然氧化层,是实现裸硅表面的关键原料;盐酸和硝酸则主要用于去除金属杂质,通过络合反应溶解金属离子。碱类原材料以氢氧化铵(NH₄OH)常用,常与过氧化氢和水组成标准清洗液(SC-1),用于去除颗粒和部分金属杂质。
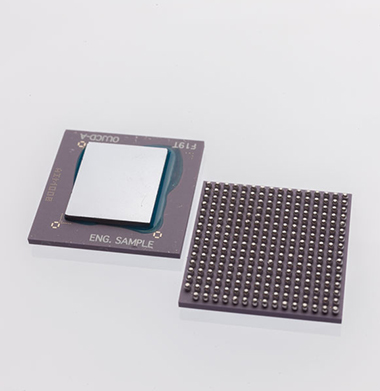
在氧化剂方面,过氧化氢(H₂O₂)是使用频繁的一种,既可与酸或碱形成清洗液,又能分解为水和氧,清洁过程较为环保。还原剂如氢气(H₂)**或某些有机还原成分也用于特定的气相或湿法还原清洗流程中,帮助去除特定类型的污染。
有机溶剂方面,异丙醇(IPA)、丙酮、甲醇和N-甲基吡咯烷酮(NMP)**等常用于光刻胶残留物的去除。其中IPA因其挥发性好、残留低而广泛应用于干燥过程;NMP因其溶解能力强,多用于清洗顽固残留。所有清洗步骤中,超纯水(UPW)**都是基础原料之一,作为稀释液和漂洗液使用,用量大,对其纯度要求也高,不含金属离子、有机物或微粒。
此外,为配合某些干法或气相清洗工艺,氮气(N₂)、氩气(Ar)、臭氧(O₃)、**氟化氢气体(HF气)**等也作为原材料投入使用。其中,臭氧常与水配合生成臭氧水,用于替代传统强酸清洗流程,具备更强的氧化性和环境友好性。
综上,半导体清洗工艺中的原材料种类繁多,涉及无机酸碱、有机溶剂、高纯气体及超纯水等多个类别。合理组合使用这些原料,是实现高洁净度、高良率和高可靠性的基础,直接影响芯片制造的成品率和性能表现。